I halvledarfabriker, FoU-laboratorier och optiska beläggningsanläggningar är det avgörande att känna till den exakta tjockleken och de optiska egenskaperna hos tunna filmer – men traditionella kontaktmetoder kan skada känsliga prover eller missa viktiga data. Idag tillkännager MSK (Tianjin) International Trading CO.,Ltd. sin senaste spektroskopiska ellipsometer, ett icke-förstörande tjockleksmätningsinstrument konstruerat förmätning av skivtjocklek, brytningsindexanalys och karakterisering av flerskiktsstackar.
Detta nya system kombinerar ett brett spektralområde, hög känslighet och användarvänlig modelleringsprogramvara – allt i en kompakt plattform av forskningsklass. Oavsett om du behöver mäta ultratunna grindoxider, antireflexbeläggningar på solceller eller komplexa OLED-stackar, levererar MSK:s spektroskopiska ellipsometer tillförlitliga, repeterbara data utan att kontakta eller skada ditt prov.
"Ingenjörer kämpar ofta med att hitta en balans mellan precision, hastighet och provsäkerhet,"sade en högre produktchef på MSK.”Vår spektroskopiska ellipsometer löser det – som ett verkligt tjockleksmätningsinstrument tillhandahåller den mätning av wafertjocklek och analys av optiska konstanter på några sekunder, utan risk för repor eller kontaminering.”
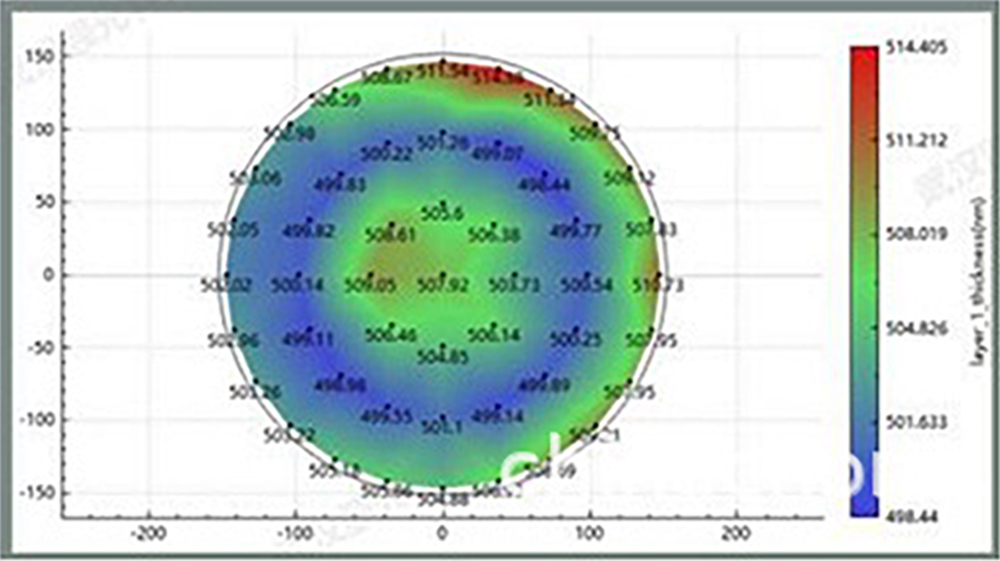

Varför välja denna spektroskopiska ellipsometer som ditt tjockleksmätningsinstrument
Till skillnad från profilerare med en våglängd eller mekaniska profilerare använder denna spektroskopiska ellipsometer polariserat ljus för att analysera hur en tunn film modifierar ljusets polarisationstillstånd. Från den mätningen beräknar den flera parametrar samtidigt:
- Filmtjocklek (från ett lager till komplexa flerlagerstaplar)
- Brytningsindex (n) och extinktionskoefficient (k)
- Optiskt bandgap (Eg)
- Ytjämnhet
Som ett mångsidigt tjockleksmätningsinstrument hanterar den tjocklekar från ultratunna (subnanometer) till relativt tjocka filmer – vilket gör den lämplig för allt från atomlagerdeponering till polymerbeläggningar i mikronskala.
Icke-förstörande mätning av skivtjocklek – avgörande för halvledarproduktion
För tillverkning av halvledare,mätning av skivtjocklekär avgörande för att kontrollera deponerings-, etsnings- och CMP-processer. Mekaniska stylusprofilerare kan dock repa mjuka filmer, och optiska reflektometrar saknar ofta känslighet för flerskiktsstaplar.
MSK:s spektroskopiska ellipsometer övervinner dessa begränsningar:
- Kontaktfri och icke-förstörande – ingen risk för skador på mönstrade wafers eller ömtåliga filmer
- Hög känslighet – kan detektera variationer i tjocklek på subnanometernivå över skivan
- Flerskiktsanalys – mäter enskilda lager i komplexa staplar (t.ex. SiO₂/Si₃N₄/poly-Si) utan överhörning
Systemet inkluderar en automatisk kartläggningsfas som stöder wafers upp till 8 tum (200 mm) med exakt positionering. Användare kan generera 2D- och 3D-tjockleksfördelningskartor med ett enda klick – perfekt för övervakning av processuniformitet.
Bortom halvledare: Brett tillämpningsområde
Även om den är optimerad för mätning av wafertjocklek, används denna spektroskopiska ellipsometer i många branscher:
- Platta bildskärmar – mäter OLED- och TFT-lagertjocklekar
- Fotovoltaik – karakteriserar antireflexbeläggningar, transparenta ledande oxider och absorberande lager
- Optiska beläggningar – verifiera bandpassfilter, antireflexstackar och högreflekterande speglar
- Materialvetenskap – studera tunna filmer, 2D-material och polymerer
- Biosensing – detektera molekylära lager på funktionaliserade ytor
Instrumentets breda spektralområde (från ultraviolett till nära infrarött) gör det möjligt att karakterisera material från djup UV-litografifilmer till infraröda optiska beläggningar.
Avancerad men ändå lättanvänd: Programvara som fungerar för dig
Ett kraftfullt tjockleksmätningsinstrument måste också vara praktiskt för dagligt bruk. MSK:sspektroskopisk ellipsometerlevereras med omfattande analysprogramvara som innehåller:
- Förbyggd databas med optiska konstanter – över 100 material inklusive vanliga halvledare, dielektrikum och metaller
- Multipla dispersionsmodeller – Cauchy, Sellmeier, Tauc-Lorentz, B-spline, oscillatorer med flera
- Flerskiktsanpassning – stöder upp till 30 lager, inklusive graderade gränssnitt och ytjämnheter
- Kartläggning med ett klick – genererar automatiskt tjockleksuniformitetsrapporter för wafers och stora substrat
- Offline-licensiering – möjliggör dataanalys på separata datorer utan att instrumentet är uppkopplat
Det guidade, interaktiva gränssnittet minskar inlärningstiden – nya användare kan utföra rutinmässiga mätningar av wafertjocklek inom några minuter.
Utformad för forsknings- och produktionsmiljöer
MSK erbjuder denna spektroskopiska ellipsometer i flera konfigurationer för att passa dina behov:
- Bänkmonterat system – perfekt för FoU-laboratorier och universitetsforskning
- Mappningskonfiguration – inkluderar högprecisions-X/Y-steg för automatiserad waferskanning
- Anpassningsbara spektralområden – från djup UV (193 nm) till kortvågig infraröd strålning (2500 nm)
- Temperaturkontrollerade scenalternativ – för in-situ-mätningar upp till 1000 °C
Instrumentet använder dubbelroterande kompensatorteknik, som mäter alla 16 Mueller-matriselement i en enda mätning. Detta ger rikare data än konventionella ellipsometrar – särskilt användbart för anisotropa eller depolariserande prover.
Tillförlitlig prestanda för kritisk kvalitetskontroll
För produktionsmiljöer är repeterbarhet allt. MSK:s spektroskopiska ellipsometer ger exceptionell stabilitet tack vare:
- Halvledarkylda detektorer – lågt brus, högt dynamiskt omfång
- Laserautofokus – bibehåller en konsekvent fokusposition över hela provet
- Stabil optisk vägdesign – minimerar avvikelser mellan kalibreringar
Systemet uppfyller rigorösa branschstandarder, och MSK tillhandahåller tredjepartsmetrologiska rapporter för att verifiera absolut tjockleksnoggrannhet på standardprover.
Anpassning och support – Skräddarsytt för din applikation
MSK förstår att varje tunnfilmsapplikation är unik. Därför erbjuder företaget:
- Anpassade spektralområdesförlängningar – välj de band som matchar dina material
- Specialiserade provtagningssteg – för icke-standardiserade skivstorlekar eller udda formade substrat
- Programvaruanpassning – lägg till specifika analysmodeller eller automatiseringsrutiner
- Installation och utbildning på plats – få ditt team snabbt igång
Eftersom detta är ett högprecisionsinstrument är priset som visas på produktsidan endast en handpenning. MSK uppmanar seriösa köpare att kontakta säljteamet för en exakt offert baserad på er önskade konfiguration.

Gratis teknisk konsultation och demonstration
Är du osäker på om ellipsometri är rätt för ditt material? MSK erbjuder kostnadsfri teknisk konsultation.
Tillgänglighet och kontaktinformation
Den nya spektroskopiska ellipsometerserien finns tillgänglig för globala beställningar omedelbart. För att begära en offert, få en produktbroschyr eller boka en live online-demo:
Email: molly@mskcnctools.com
Telefon: 0086-13602071763
Web:www.mskcnctools.com
MSK välkomnar förfrågningar från halvledarfabriker, forskningsinstitut, tillverkare av optiska beläggningar och solcellsproducenter – från enskilda enheter till flera system.
Om MSK CNC-verktyg
MSK (Tianjin) Cutting Technology Co., Ltd. grundades 2015 och är ISO 9001-certifierat. Företaget specialiserar sig på högprecisionsmätinstrument och CNC-skärverktyg. Med tysk och taiwanesisk tillverkningsutrustning och ett dedikerat FoU-team betjänar MSK kunder i Europa, Amerika och Asien. Företagets uppdrag är att tillhandahålla avancerade, tillförlitliga och kostnadseffektiva lösningar för materialkarakterisering och bearbetning.
Publiceringstid: 10 april 2026



