I halvlederfabrikker, forsknings- og udviklingslaboratorier og optiske belægningsfaciliteter er det afgørende at kende den nøjagtige tykkelse og de optiske egenskaber af tyndfilm – men traditionelle kontaktmetoder kan beskadige sarte prøver eller gå glip af afgørende data. I dag annoncerer MSK (Tianjin) International Trading CO.,Ltd. sit nyeste spektroskopiske ellipsometer, et ikke-destruktivt tykkelsesmåleinstrument konstrueret tilmåling af wafertykkelse, brydningsindeksanalyse og karakterisering af flerlagsstak.
Dette nye system kombinerer et bredt spektralområde, høj følsomhed og brugervenlig modelleringssoftware – alt sammen i en kompakt platform i forskningsklassen. Uanset om du har brug for at måle ultratynde gateoxider, antireflekterende belægninger på solceller eller komplekse OLED-stabler, leverer MSK's spektroskopiske ellipsometer pålidelige, repeterbare data uden at berøre eller beskadige din prøve.
"Ingeniører kæmper ofte med at finde balancen mellem præcision, hastighed og prøvesikkerhed,"sagde en ledende produktchef i MSK."Vores spektroskopiske ellipsometer løser det – som et ægte tykkelsesmåleinstrument leverer det wafertykkelsesmåling og optisk konstantanalyse på få sekunder uden risiko for ridser eller kontaminering."
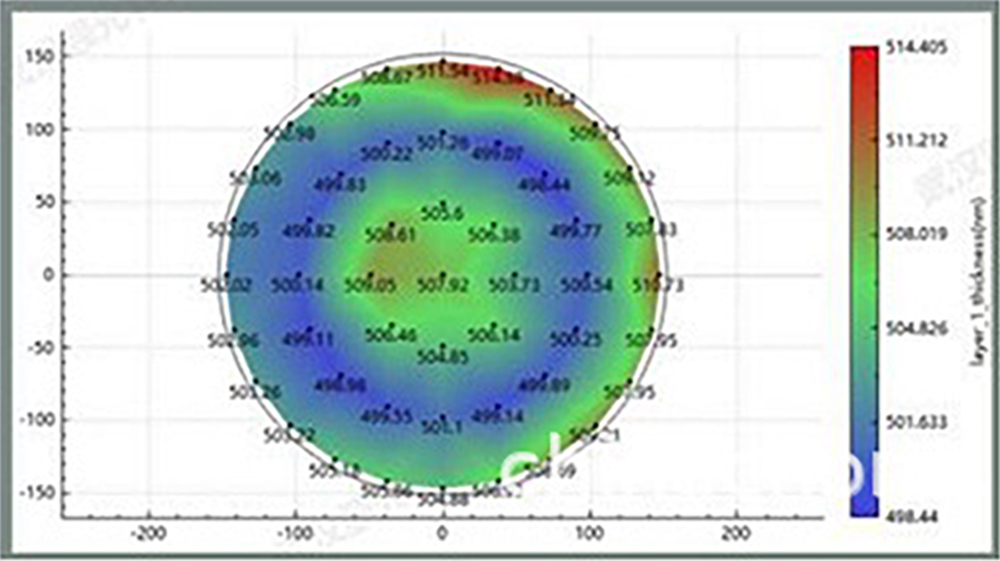

Hvorfor vælge dette spektroskopiske ellipsometer som dit tykkelsesmåleinstrument
I modsætning til profileringsapparater med én bølgelængde eller mekaniske apparater bruger dette spektroskopiske ellipsometer polariseret lys til at analysere, hvordan en tynd film ændrer lysets polarisationstilstand. Ud fra denne måling beregner det flere parametre samtidigt:
- Filmtykkelse (enkeltlags til komplekse flerlagsstabler)
- Brydningsindeks (n) og ekstinktionskoefficient (k)
- Optisk båndgab (Eg)
- Overfladeruhed
Som et alsidigt tykkelsesmåleinstrument håndterer det tykkelser fra ultratynde (subnanometer) til relativt tykke film – hvilket gør det velegnet til alt fra atomlagsaflejring til polymerbelægninger på mikronskala.
Ikke-destruktiv måling af wafertykkelse – afgørende for halvlederproduktion
Til fremstilling af halvledere,måling af wafertykkelseer afgørende for at kontrollere aflejrings-, ætsnings- og CMP-processer. Mekaniske stylusprofilere kan dog ridse bløde film, og optiske reflektometre mangler ofte følsomhed over for flerlagsstabler.
MSK's spektroskopiske ellipsometer overvinder disse begrænsninger:
- Kontaktfri og ikke-destruktiv – ingen risiko for beskadigelse af mønstrede wafere eller sarte film
- Høj følsomhed – i stand til at detektere variationer i tykkelse på subnanometerniveau på tværs af waferen
- Flerlagsanalyse – måler individuelle lag i komplekse stakke (f.eks. SiO₂/Si₃N₄/poly-Si) uden krydstale
Systemet inkluderer en automatisk kortlægningsfase, der understøtter wafere op til 8 tommer (200 mm) med præcis positionering. Brugere kan generere 2D- og 3D-tykkelsesfordelingskort med et enkelt klik – ideelt til overvågning af procesensartethed.
Ud over halvledere: Bredt anvendelsesområde
Selvom dette spektroskopiske ellipsometer er optimeret til måling af wafertykkelse, tjener det mange brancher:
- Fladskærme – måler OLED- og TFT-lagtykkelser
- Fotovoltaik – karakteriserer antireflekterende belægninger, transparente ledende oxider og absorberende lag
- Optiske belægninger – verificer båndpasfiltre, antirefleksionsstabler og spejle med høj reflektionsevne
- Materialevidenskab – studerer tyndfilm, 2D-materialer og polymerer
- Biosensing – detekter molekylære lag på funktionaliserede overflader
Instrumentets brede spektralområde (fra ultraviolet til nær-infrarødt) gør det muligt at karakterisere materialer fra dyb-UV-litografifilm til infrarøde optiske belægninger.
Avanceret, men brugervenlig: Software, der fungerer for dig
Et kraftigt tykkelsesmåleinstrument skal også være praktisk til daglig brug. MSK'sspektroskopisk ellipsometerleveres med omfattende analysesoftware, der indeholder:
- Forudbygget database med optiske konstanter – over 100 materialer, herunder almindelige halvledere, dielektriske materialer og metaller
- Flere dispersionsmodeller – Cauchy, Sellmeier, Tauc-Lorentz, B-spline, oscillatorer og mere
- Flerlagsmontering – understøtter op til 30 lag, inklusive graduerede grænseflader og overfladeruhed
- Kortlægning med ét klik – genererer automatisk tykkelsesensartethedsrapporter for wafere og store substrater
- Offlinelicensering – muliggør dataanalyse på separate computere uden at binde instrumentet
Den guidede, interaktive brugerflade reducerer træningstiden – nye brugere kan udføre rutinemæssig wafertykkelsesmåling på få minutter.
Designet til forsknings- og produktionsmiljøer
MSK tilbyder dette spektroskopiske ellipsometer i flere konfigurationer, der passer til dine behov:
- Bordsystem – perfekt til forsknings- og udviklingslaboratorier og universitetsforskning
- Kortlægningskonfiguration – inkluderer højpræcisions X/Y-trin til automatiseret waferscanning
- Tilpassede spektralområder – fra dyb UV (193 nm) til kortbølget infrarød (2500 nm)
- Temperaturstyrede trinmuligheder – til in-situ målinger op til 1000 °C
Instrumentet bruger dobbeltroterende kompensatorteknologi, som måler alle 16 Mueller-matrixelementer i én optagelse. Dette giver mere omfattende data end konventionelle ellipsometre – især nyttigt til anisotrope eller depolariserende prøver.
Pålidelig ydeevne til kritisk kvalitetskontrol
I produktionsmiljøer er repeterbarhed altafgørende. MSK's spektroskopiske ellipsometer leverer enestående stabilitet takket være:
- Halvlederkølede detektorer – lav støj, højt dynamisk område
- Laser autofokus – opretholder ensartet fokusposition på tværs af prøven
- Stabilt optisk stidesign – minimerer afdrift mellem kalibreringer
Systemet opfylder strenge branchestandarder, og MSK leverer tredjeparts metrologirapporter for at verificere absolut tykkelsesnøjagtighed på standardprøver.
Tilpasning og support – skræddersyet til din applikation
MSK forstår, at enhver tyndfilmsanvendelse er unik. Derfor tilbyder virksomheden:
- Brugerdefinerede spektralområdeudvidelser – vælg de bånd, der matcher dine materialer
- Specialiserede prøvefaser – til ikke-standard waferstørrelser eller mærkeligt formede substrater
- Softwaretilpasning – tilføj specifikke analysemodeller eller automatiseringsrutiner
- Installation og træning på stedet – få dit team hurtigt op i fart
Da dette er et højpræcisionsinstrument, er prisen vist på produktsiden kun et depositum. MSK opfordrer seriøse købere til at kontakte salgsteamet for et præcist tilbud baseret på din ønskede konfiguration.

Gratis teknisk konsultation og demonstration
Er du ikke sikker på, om ellipsometri er det rigtige valg til dit materiale? MSK tilbyder gratis teknisk rådgivning.
Tilgængelighed og kontaktoplysninger
Den nye serie spektroskopiske ellipsometere er tilgængelig med det samme til globale ordrer. For at anmode om et tilbud, modtage en produktbrochure eller arrangere en live online demo:
Email: molly@mskcnctools.com
Telefon: 0086-13602071763
Web:www.mskcnctools.com
MSK modtager gerne henvendelser fra halvlederfabrikker, forskningsinstitutter, producenter af optiske belægninger og solcelleproducenter – fra enkeltstående enheder til flere systemer.
Om MSK CNC-værktøjer
MSK (Tianjin) Cutting Technology Co., Ltd. blev grundlagt i 2015 og er ISO 9001-certificeret. Virksomheden har specialiseret sig i højpræcisions-metrologiinstrumenter og CNC-skæreværktøjer. Med tysk og taiwansk produktionsudstyr og et dedikeret forsknings- og udviklingsteam betjener MSK kunder i hele Europa, Amerika og Asien. Virksomhedens mission er at levere avancerede, pålidelige og omkostningseffektive løsninger til materialekarakterisering og bearbejdning.
Udsendelsestidspunkt: 10. april 2026



