High Precision Spectroscopic Ellipsometer | Non-Destructive Thin Film Thickness & Refractive Index Measurement System

Ordering Instructions
Due to the special nature of the product, the price shown on the page is a deposit price, not the actual price. Please contact customer service for a quote.
Orders placed directly without prior contact cannot be shipped! Thank you for your cooperation! For more product information, please contact customer service to receive product brochures.
Key Measurements
Film Thickness (single to multi-layer)
Refractive Index (n) & Extinction Coefficient (k)
Optical Band Gap (Eg)
Surface Roughness
Technical Highlights
Wide Spectral Range: UV to NIR coverage for versatile material analysis
High Sensitivity: Capable of measuring ultra-thin films down to sub-nanometer scale
Non-Contact & Non-Destructive: Ideal for sensitive samples in R&D and production environments
Advanced Modeling Software: Supports complex multi-layer stack analysis with user-friendly workflows
Applications
This system is widely adopted in semiconductor manufacturing, optical coating, flat panel displays, photovoltaic (solar cell) development, materials science research, and biosensing.
Why Choose Our Solution
As a professional manufacturer with strong R&D capabilities, we offer factory-direct pricing, customizable configurations, and dedicated technical support. Whether you require a benchtop system for laboratory analysis or an in-line solution for production monitoring, we can tailor the instrument to your specific measurement needs.
Request a Quote
Contact us today to discuss your application or request a quote. Our team provides complimentary technical consultation to help you select the optimal thin film measurement solution.
Main Technical Parameters
1. Measurement Capabilities: 16th order Mueller matrix elements, polarization spectrum Psi/Delta, refractive index, thickness, birefringence, and dielectric constant, etc.
2. Spectral Range: 210nm-1690nm
3. Wavelength Spacing: ≤0.8nm@210-1000nm, ≤3.5nm@1000-1690nm
4. Single-Point Measurement Time: ≤10s
5. Micro-spot Size: ≤200μm
6. Modulation Technology: PCSCA dual rotary compensator system modulation
7. Automatic Sample Stage: Z-axis automatic focusing, maximum travel 18mm, minimum step 1µm
8. Film thickness repeatability accuracy: ≤0.005nm (100nm SiO2/Si, 30 repeated measurements, calculated as 1σ)
9. Refractive index repeatability accuracy: ≤0.0002 (100nm SiO2/Si, 30 repeated measurements, calculated as 1σ)
10. Absolute film thickness accuracy: ≤0.5% (100nm SiO2/Si, third-party metrology report provided)
11. Mapping function: Employs a high-precision x/y type automatic scanning stage, supports automatic positioning and scanning measurement of 2/4/6/8-inch substrates, repeatability accuracy ≤6μm, one-click generation of 2D/3D film thickness distribution maps
12. Laser ranging and focusing: Automatic focal length positioning via laser reflection optical path, focusing travel ≤3mm
13. Difference model: Automatically calculates psi-diff and delta-diff difference data
14. Analysis software: Features at least 5 different measurement modes, a built-in n/k database for over 100 optical materials, and supports creating custom databases; possesses testing and modeling analysis capabilities for single-layer, multi-layer (up to 30 layers), and composite alternating thin films, including cauchy, Sellmeier, Tauc-Lorentz, Bspline, and Oscillator models, and supports offline software licensing.
Technical Specifications
I. Equipment Introduction
The ME-Mapping Spectroellipsometry features dual-rotation compensator modulation technology combined with high-precision data analysis algorithms. It can acquire all 16 elements of the full Mueller matrix and polarization spectrum in a single measurement, enabling rapid and non-destructive sample measurement. The instrument boasts a stable optical path design and employs a semiconductor-cooled detector, acquiring light intensity signals within seconds. It offers faster measurement speed and higher accuracy, supporting precise measurement of parameters such as thickness, refractive index, extinction coefficient, and optical dielectric constant for various thin film materials. Furthermore, it can be customized with different sized "wafer repeatable positioning stages" for multi-point mapping scanning measurements of various large-sized samples.

II. Application Scope
Ellipsometrists are mainly used in semiconductors, flat panel displays, solar photovoltaics, optical thin films, optical communications, and nanomaterials.
III. Overall Technical Requirements
1. Technical Specifications:
1.1 Measurement Parameters: 16th-order Mueller matrix elements, Psi/Delta, refractive index, thickness, birefringence, and dielectric constant, etc.
1.2 Spectral Range: 210nm-1690nm;
1.3 Single-point Measurement Time: ≤10s;
1.4 Microspot Size: ≤200μm;
1.5 Modulation Technology: PC1SCA dual rotation compensation modulation;
1.6 Automatic Sample Stage: Supports automatic z-axis focusing, maximum travel 18mm, minimum step 1μm;
1.7 Film Thickness Repeatability Accuracy: ≤0.005nm (100nm SiO2/Si, 30 repeated measurements, calculated 1σ);
1.8 Refractive Index Repeatability Accuracy: ≤0.0002 (100nm SiO2/Si, 30 repeated measurements, calculated 1σ);
1.9 Absolute Film Thickness Accuracy: ≤0.5% (100nm SiO2/Si, third-party metrology report provided); μm
1.10 Mapping Function: Employs a high-precision x/y-type automatic scanning stage, supporting automatic positioning and scanning measurement of 2/4/6/8-inch substrates, with a repeatability accuracy ≤6μm, and one-click generation of 2D/3D film thickness distribution maps;
1.11 Laser Rangefinding and Focusing: Automatically positions the focal length using the laser reflection optical path, with a focus-finding travel ≤3mm;
1.12 Film Thickness Measurement Range: 1nm-10μm;
1.13 Difference Model: Automatically calculates psi-diff and delta-diff difference data;
1.14 Analysis Software:
* Spectroscopic Measurement Capabilities: 16 elements of the full Mueller matrix, Psi/Delta polarization spectroscopy, N/C/S, depolarization, etc.;
* Data Analysis Capabilities: Capable of analyzing the thickness and optical constants (n, k) of single-layer and multi-layer (up to 20 layers) isotropic and anisotropic thin film materials;
* Supports models for optical constants, refractive index gradient distribution, equivalent media, roughness, etc., of multi-component thin films and bulk materials;
* Supports common optical constant models and common oscillator models (Cauchy model, Lorentz model, Gaussian model, Drude, Sellmeier, etc.), and supports graphical multi-oscillator hybrid model fitting;
* Supports outputting 2D/3D topographic images, viewing historical data, and exporting and editing data and corresponding reports;
* Data Output Formats: TXT, CSV, SNAP snapshot, raw spectrum, DAT, etc.;
* Supports phase delay measurement, capable of testing phase delay, azimuth angle, optical rotation angle, amplitude ratio, order, etc.;
* Possesses 1D/2D periodic grating structure analysis and modeling functions.
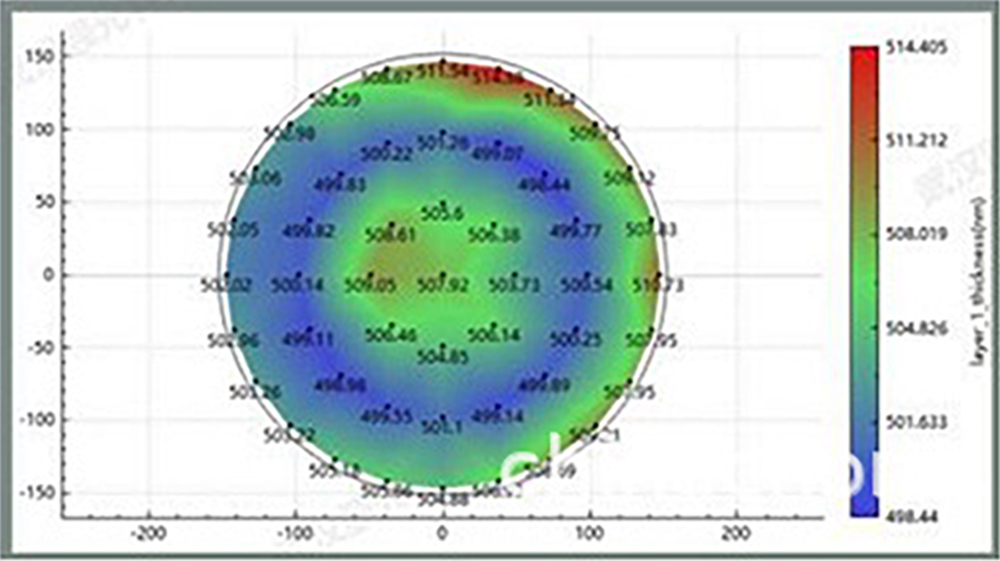

2. Configuration List:
1) One set of ellipsometer main unit;
2) One set each of ellipsometry arm and analyzer arm;
3) One set of automatic sample stage;
4) One set of analysis software;
5) One set of standard slides;
6) One computer;
7) One set of debugging tools;
8) One set of micro-spot assembly;
9) One vacuum adsorption pump;
10) One mapping scanning stage.
3. Measurement and Control Computer
Uses a commercial industrial PC with Windows 10 operating system; CPU: i7 processor; Memory: 15GB; Hard Disk: 1TB; LCD monitor: 24-inch; includes mouse and keyboard.
4. Environmental and Power Requirements:
1) Platform Requirements: 2.0m (length) x 1.2m (width), load capacity greater than 100kg (optical vibration isolation recommended).
2) Operating Temperature Range: 20~30°C
3) Relative Humidity: 35%~60%RH
4) Power Supply Voltage: 220VAC
5) Phase Current: RMS value less than 4A (220VAC);
6) Maximum Power: 800W
Ellipsometry Measurement Object
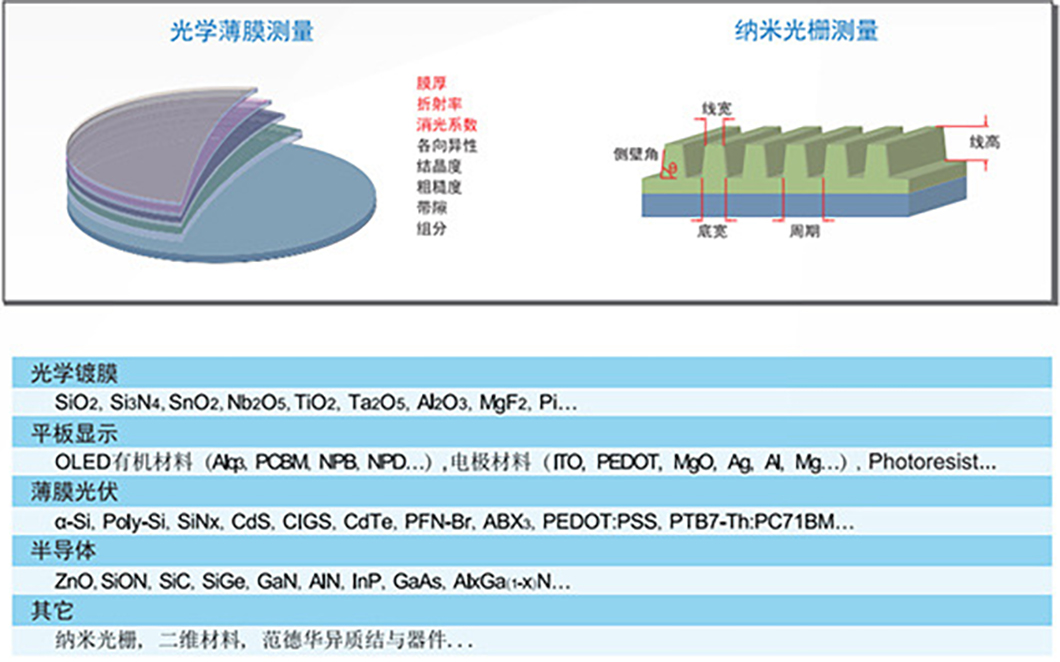
Ellipsometry Measurement Principle

Ellipsometry Analysis Process
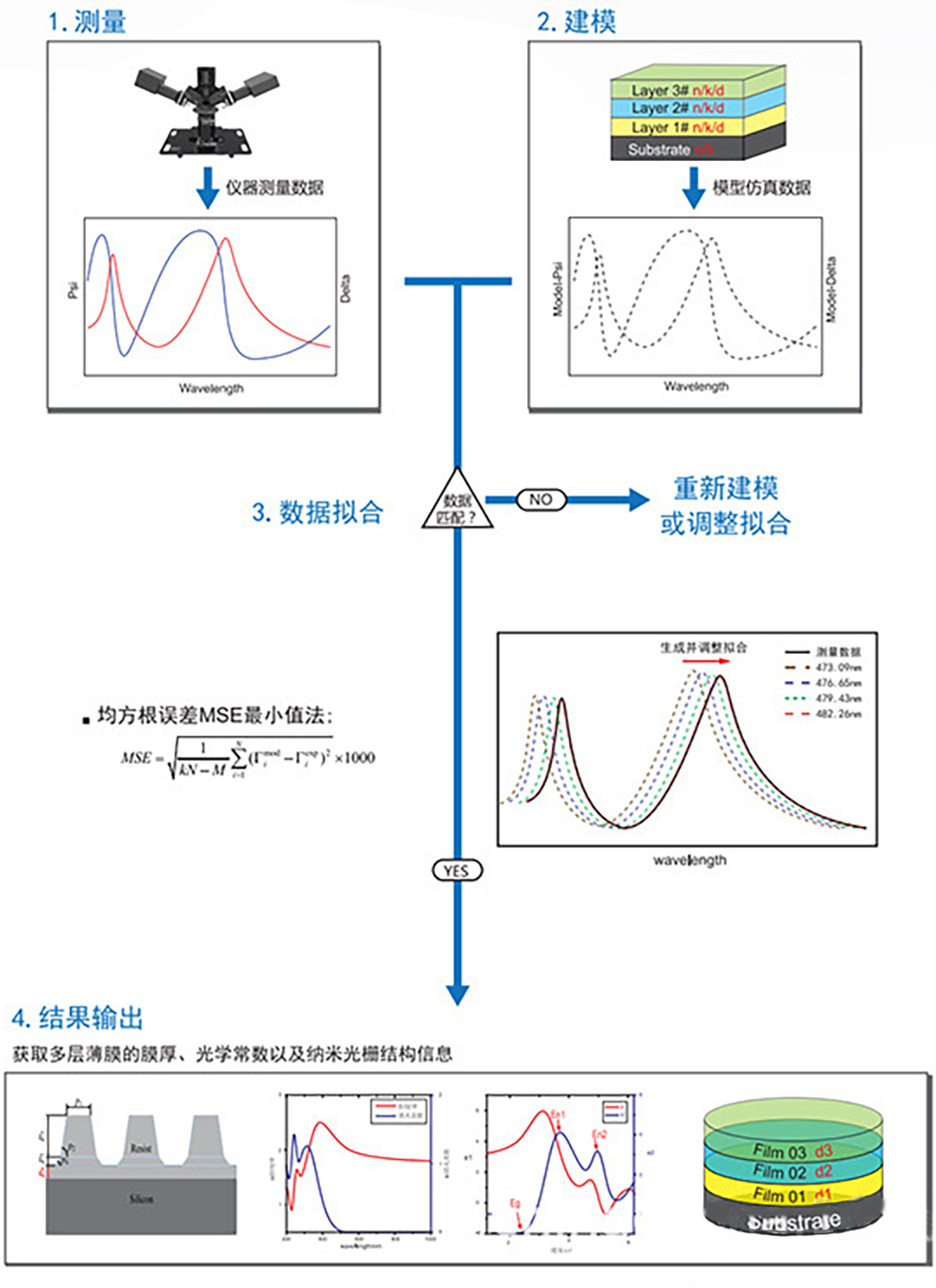
Muller Matrix Ellipsometry


ME-L Mueller Matrix Ellipsometry
Research-grade fully automatic high-precision Mueller matrix ellipsometry
Fully automatic angle adjustment and focusing technology, one-click rapid measurement
Guided interactive human-machine interface, convenient software operation experience
Rich material database and algorithm model library, powerful data analysis capabilities
Technical Specifications
| Model Number | ME-L |
| Applications | Research/Enterprise Grade |
| Basic Functions | Psi/Delta, R/T, Mueller Matrix, and other optical sensors |
| Spectrum Analysis | 380-1000nm (supports expansion to 193-2500nm) |
| Single Measurement Time | ≤15s |
| Repeatability Measurement Accuracy | 0.005nm |
| Absolute Accuracy (Through-through Measurement Air) | Ellipsometry parameters: 4 = 45 ± 0.05°, A = 0 ± 0.1° Muller matrix: Diagonal element m = 10.005 Off-diagonal element m = 0 ± 0.005 |
| Refractive Index Repeatability Accuracy | 0.0005 |
| Spot Size | Large spot size: 2-4 mm Small spot size: 200 μm/100 μm Ultra-small spot size: 50 μm (depending on wavelength) |
The repeatability accuracy index is based on 30 repeatable measurements of a 100nm SiO2/Si standard sample;
The specific technical parameters of the instrument are related to the actual functional modules and accessories, and the data in the table are for reference only.
Optional Configurations
| Band Selection | VN: 380-1650nm |
| V: 380-1000nm | UN: 210-1650nm |
| UV: 245-1000nm | DN: 193-1650nm |
| UV+: 210-1000nm | UN+: 210-2500nm |
| DUV: 193-1000nm | DN+: 193-2500nm |
Angle Selection
Fixed: 65°
Automatic: 45-90°
Manual: 45-90° (5° increments)
Other Options
Mapping Options: 100*100mm/200*200mm
Temperature Control Stage: 190-550°C/RT-1000°C
About Us

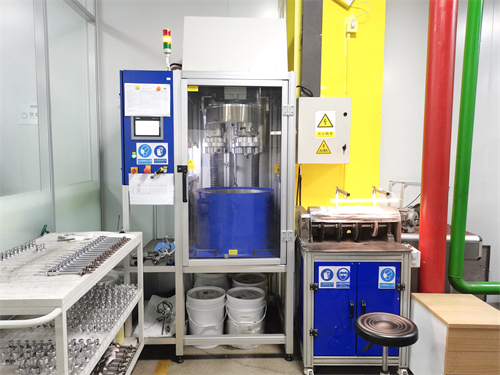



Factory Profile

Why Choose Us





FAQ
Q1: Who are we?
A1: Founded in 2015, MSK (Tianjin) Cutting Technology CO.Ltd has grown continuously and passed Rheinland ISO 9001
authentication.With German SACCKE high-end five-axis grinding centers, German ZOLLER six-axis tool inspection center, Taiwan PALMARY machine and other international advanced manufacturing equipment, we are committed to producing high-end,professional and efficient CNC tool.
Q2: Are you trading company or manufacturer?
A2: We are the factory of carbide tools.
Q3: Can you send products to our Forwarder in China?
A3: Yes,if you have Forwarder in China,we will glad to send products to him/her.
Q4: What terms of payment are acceptable?
A4: Normally we accept T/T.
Q5: Do you accept OEM orders?
A5: Yes, OEM and customization are available, and we also provide label printing service.
Q6: Why should you choose us?
A6:1) Cost control - purchasing high-quality products at an appropriate price.
2) Quick response - within 48 hours, professional personnel will provide you with a quote and address your concerns.
3) High quality - The company always proves with sincere intention that the products it provides are 100% high-quality.
4) After sales service and technical guidance - The company provides after-sales service and technical guidance according to customer requirements and needs.













